Содержание
Домашнее задание №1 Расчет логической схемы.
- Нарисовать в масштабе топологии и технологические сечения транзисторов и резисторов.
- Рассчитать spice-параметры моделей транзисторов схемы.
- Описать принцип работы схемы.
- Используя рассчитанные параметры моделей промоделировать схему в SPICE и построить:
- передаточную характеристику схемы: UВЫХ(UВХ), определить по ней уровни логического нуля (U0) и единицы (U1), запас помехоустойчивости схемы;
- зависимость потребляемого схемой тока от входного напряжения IПОТР(UВХ) и рассчитать средний потребляемый ток;
- переходные характеристики схемы: UВЫХ(t) и UВХ(t), определить по ним времена задержек и фронтов переключения, максимальную рабочую частоту схемы (fmax);
- рассчитать статическую и динамическую потребляемую мощность.
- Оформить отчет о домашнем задании (отчет должен обязательно содержать титульный лист с номером варианта, задание и исходные данные).
Для расчета spice-параметров рекомендуется использовать программу Mathcad. Для создания топологии транзистора и технологического разреза желательно использовать редактор векторной графики (например Corel Draw). Моделирование схемы проводить в программе LTSPICE.
Руководство по выполнению домашней работы №1.
Биполярный транзистор
Исходные данные для расчета биполярного транзистора:
| Параметр | Описание |
| xjк=1…3 | Глубина залегания p-n перехода база-коллектор, мкм |
| xjэ=0.5…2.5 | Глубина залегания эмиттерного p-n перехода, мкм |
| wБ=xjк—xjэ | Толщина активной базы, мкм |
| wэпи=5…10 | Толщина эпитаксиального слоя, мкм |
| xjn=5…12 | Толщина скрытого n+ слоя, мкм |
| NДЭ(0)=(2…10)1020 | Концентрация донорной примеси в эмиттерной области: на
поверхности, см-3 |
| NДЭ(xjэ)=(1…10)1017 | Концентрация донорной примеси в эмиттерной области: у
эмиттерного перехода, см-3 |
| NАБ(xjэ)=(1…5)1017 | Концентрация акцепторной примеси в области базы: у
эмиттерного перехода, см-3 |
| NАБ(xjк)=(5…10)1016 | Концентрация акцепторной примеси в области базы: у
коллекторного перехода, см-3 |
| NДК=(0.5…5)1016 | Концентрация донорной примеси в эпитаксиальной пленке
коллектора, см-3 |
| эпи=0.05…0.5 | Удельное объемное сопротивление коллекторной области,
Омсм |
| RБА=(1…10)103 | Поверхностное сопротивление активной области базы (под
эмиттером), Ом/□ |
| RБП=100…300 | Поверхностное сопротивление пассивной области базы (вне
эмиттера), Ом/□ |
| LpЭ5 | Диффузионная длина дырок в эмиттере, мкм |
| LnБ5 | Диффузионная длина электронов в базе, мкм |
| LpК5 | Диффузионная длина дырок в коллекторе, мкм |
| DpЭ11 | Коэффициент диффузии дырок в эмиттере, см2/с |
| DnБ | Коэффициент диффузии электронов в базе, см2/с |
| DpК14 | Коэффициент диффузии дырок в коллекторе, см2/с |
| ni=1.51010 (Si) | Концентрация носителей зарядов в собственном
полупроводнике, см-3 |
| =12 (Si), =3.9 (SiO2), | Относительная диэлектрическая проницаемость
полупроводника, диэлектрика |
| q=1.610-19 | Заряд электрона, Кл |
| n≈1200…1400 (Si) | Подвижность электронов в объеме базы, см2/(Вс) |
| η=2.5 | Коэффициент, учитывающий градиент примеси в базе |
| T 0.025 | Тепловой потенциал при комнатной температуре (Т=300 К), В |
| э=0.0005…0.001 | Удельное объемное сопротивление эмиттерной области, Омсм |
Расчет spice-параметров биполярного транзистора
Описание биполярного транзистора в SPICE.
Q1 <узел коллектора> <узел базы> <узел эмиттера> < название модели >
.model <название модели> npn[или pnp](<список параметров>).
Набор spice-параметров биполярного транзистора.
| № | Параметр | Описание | Примечание |
| 1 | BF | коэффициент усиления тока базы в
нормальном режиме |
рассчитывается |
| 2 | BR | коэффициент усиления тока базы в
инверсном режиме |
рассчитывается |
| 3 | IS | ток насыщения, А | рассчитывается |
| 4 | RB | сопротивление базы, Ом | рассчитывается |
| 5 | RC | сопротивление коллектора, Ом | рассчитывается |
| 6 | TF | время пролета базы, с | рассчитывается |
| 7 | CJE | емкость эмиттерного pn-перехода, Ф | рассчитывается |
| 8 | CJC | емкость коллекторного pn-перехода, Ф | рассчитывается |
| 9 | NF | коэффициент эмиссии эмиттерного
перехода |
задан (1.1) |
| 10 | NR | коэффициент эмиссии коллекторного
перехода |
задан (1.4) |
Коэффициент усиления тока базы в инверсном режиме (BR).
Все транзисторы проектируются исходя из минимального размера , за исключением многоэмиттерных, для которых следует добиваться минимума коэффициента передачи тока базы в инверсном режиме — BR (необходимо получить значение BR < 0.1) этот параметр рассчитывается по формуле:
B DnБ SЭ KX expwБ / 2LA
R pK SБ / LpK DnБ SЭM KX cthKX wБ 1/ 2LA DnБ SБ MSЭ K cthK x jК 1/ 2L
D
X
X
A
где: M – число эмиттеров, SЭ=LЭdЭ, — площадь эмиттера, SБ=LБZБ, — общая площадь базы,
D , K (1/ 2L )2 (1/ L )2 , L w / ln NДЭ (xjЭ ) .
nБ n T X
A nБ A Б
N ДК
Остальные параметры рассчитываются по следующим формулам:
Ток насыщения (IS):
S qD
n
2
IS Э nБ i .
NДЭ (xjЭ )Lа
Коэффициент усиления тока базы в нормальном режиме (BF):
2L2
BF nБ (1 ) .
2
w
Б
Сопротивление базы (RB):
R R
dЭБ .
B БП
L
Э
Сопротивление коллектора (RC):
RC=RC1+RC2.
R
wЭПИ
1 Х
2 jn
Х jЭ
,
R
wЭПИ
1 Х
2 jn
Х jK
.
C1 ЭПИ
LKK
dKK
C 2 ЭПИ
LЭ dЭ
Время пролета базы (TF):
2w2
TF Б .
DnБ (1 )
Емкости рассчитываются по формуле (CJE и CJC):
q0Si N
2VB
C S
, V ln NД (xj )NА (x j ) ; N=min(N (x ),N (x ));
p n
B T 2
i
Д j А j
S L Z
- 2xjК (L
4x2
- Z ) jК
— для коллекторного p-n – перехода,
Б Б
n
4
2x
Б Б 8
4x2
— для эмиттерного p-n – перехода,
S L d
- jЭ (L
- d ) jЭ
Э Э
4 Э Э 8
Cp-n – ёмкость p-n перехода при нулевом смещении, S — общая площадь p-n – перехода, первое слагаемое – плоское дно, второе слагаемое – цилиндрические боковые части, третье слагаемое – сферические угловые части, значения концентраций NД,NА берутся вблизи p-n перехода, VB — потенциальный барьер p-n – перехода при нулевом смещении.
Резисторы
Диффузионные резисторы
Диффузионные резисторы – формируются в полупроводниковой подложке с помощью методов диффузии или ионной имплантации.

Рис. 1. Диффузионный резистор
Чтобы использовать диффузионную область в качестве резистора, необходимо сместить в обратном направлении отделяющий ее p-n переход. Для этого подложку (n-тип) надо подключить к самому высокому потенциалу в схеме, т.е. к положительному источнику питания Е+. В данной конструкции всегда существует паразитный ток утечки.
При необходимости реализовать сопротивление большего номинала делается контур с изгибами (типа «меандр»).
R RS
l N w
изл
R RS
(KП1 KП 2 )
где RS (KП1 KП 2 ) — сопротивление контактных площадок. КП = 0,75.
Сжатый резистор (pinch, пинч-резистор)
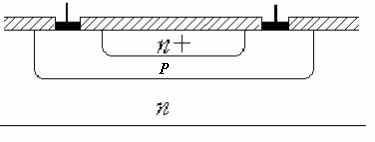
Рис. 2. Сжатый резистор
Поверхностное сопротивление сжатого p слоя, между слоями n и n+: RS= RБА.
Малые сопротивления.
Для малых сопротивлений (1…50 Ом) используются высоколегированные области
(эмиттерный n+ — слой):

Рис. 3. Высоколегированная (эмиттерная) область
В схемах малой степени интеграции используется однослойная металлизация – слой алюминия на поверхности окисла, который формирует контакты к элементам ИС и межсоединения. В этом случае возможны ситуации, когда не удается избежать пересечения проводников. В этом случае используется так называемый «подныр»: один проводник остается алюминиевой шиной, а второй проходит под ним по низкоомному резистору.
МОП-транзистор
Исходные данные для расчета МОП-транзистора:
| Параметр | Описание |
| xj=0,4…1,2 | Глубина залегания p-n перехода исток-подложка и сток-
подложка, мкм |
| L=∆…5∆ | Длина канала транзистора, мкм |
| W=∆…10∆ | Ширина канала транзистора, мкм |
| dпер=0,1 | Длина области перекрытия затвор-исток и затвор-сток, мкм |
| NП_n=(5…10)1016 | Концентрация акцепторной примеси в подложке n-канального
МОПТ, см-3 |
| NП_p=(2…8)1016 | Концентрация донорной примеси в подложке p-канального
МОПТ, см-3 |
| NЗ_n=(1…1.5)1019 | Концентрация донорной примеси в затворе n-канального
МОПТ, см-3 |
| NЗ_p=(0.5…10)1019 | Концентрация акцепторной примеси в затворе p-канального
МОПТ, см-3 |
| NС_n=(0.5…1.5)1018 | Концентрация донорной примеси в области истока/стока у pn-
перехода с подложкой в n-канальном МОПТ, см-3 |
| NС_p=(0.7…1.2)1018 | Концентрация акцепторной примеси в области истока/стока у
pn-перехода с подложкой в p-канальном МОПТ, см-3 |
| ni=1.51010 (Si) | Концентрация носителей зарядов в собственном
полупроводнике, см-3 |
| =12 (Si), =3.9 (SiO2), | Относительная диэлектрическая проницаемость
полупроводника, диэлектрика |
| q=1.610-19 | Заряд электрона, Кл |
| n≈600…400 (Si) | Подвижность электронов в канале МОПТ, см2/(Вс) |
| p≈300…200 (Si) | Подвижность дырок в канале МОПТ, см2/(Вс) |
| T 0.025 | Тепловой потенциал при комнатной температуре (Т=300 К), В |
Расчет spice-параметров МОП-транзистора
Описание МОП-транзистора в SPICE.
M1 <узел стока> <узел затвора> <узел истока> <узел подложки> <название модели> L=<L>
+W=<W> AS=<AS> AD=<AD> PS=<PS> PD=<PD>
.model <название модели> nmos[или pmos](<список параметров>).
Набор spice-параметров МОП-транзистора.
| № | Параметр | Описание | Примечание |
| 1 | L | длина канала, мкм | задан |
| 2 | W | ширина канала, мкм | задан |
| 3 | AS | площадь истока, м2 | рассчитывается |
| 4 | AD | площадь стока, м2 | рассчитывается |
| 5 | PS | периметр истока, м | рассчитывается |
| 6 | PD | периметр истока, м | рассчитывается |
| 7 | LEVEL | уровень подключаемой модели | задан (3) |
| 8 | VTO | пороговое напряжение, В | рассчитывается |
| 9 | TOX | толщина подзатворного окисла, м | задан |
| 10 | XJ | глубина залегания p-n перехода
исток-подложка и сток-подложка, мкм |
задан |
| 11 | NSUB | концентрация примеси в подложке
МОПТ, см-3 |
задан |
| 12 | LD | длина области перекрытия затвор-
исток и затвор-сток, мкм |
задан |
| 13 | UO | подвижность электронов в канале
МОПТ, см2/(Вс) |
задан |
| 14 | CGSO | удельная емкость перекрытия
затвор-исток, Ф/м. |
рассчитывается |
| 15 | CGDO | удельная емкость перекрытия
затвор-сток, Ф/м. |
рассчитывается |
| 16 | CJ | удельная донная емкость перехода
исток (сток) – подложка, Ф/м2 |
рассчитывается |
| 17 | CJSW | удельная боковая емкость перехода
исток (сток) – подложка, Ф/м |
рассчитывается |
Площади областей истока и стока.
Площадь стока (AD) определяется как произведение длины области стока на ширину канала W. Площадь истока (AS) определяется как произведение длины области истока на ширину канала W.
Периметры областей истока и стока.
Периметр стока (PD) определяется как удвоенная сумма длины области стока и ширины канала
W.
Периметр истока (PS) определяется как удвоенная сумма длины области истока и ширины канала W.
Пороговое напряжение (VTO).
- канальный транзистор (подложка p-типа):
U 2
-
- Qc ,
пор мп F
4q 0Si N F
C 2
OX
COX
где МП — разность работ выхода из затвора и подложки, В:
- канальный транзистор – подложка p-типа, затвор легирован n-примесью
мп
FЗ
-
- FП
T
ln NЗ
ni
T
ln NП .
ni
|F| — абсолютное значение потенциала Ферми, В.
F T
ln N .
ni
p-канальный транзистор (подложка n-типа):
U 2
Qc ,
пор мп F
4q 0Si N F
C 2
OX
COX
где МП — разность работ выхода из затвора и подложки, В:
- канальный транзистор – подложка n-типа, затвор легирован p-примесью
мп
FЗ
-
- FП
T
ln NЗ
ni
T
ln NП .
ni
|F| — абсолютное значение потенциала Ферми, В.
F T
ln N .
ni
Q 2 108
c
Кл
см2
— плотность заряда поверхностных состояний.
СOX
oox
lox
— удельная емкость затвор-подложка (на единицу площади затвора), Ф/м2.
N – концентрация примеси в подложке.
Емкости МДП-транзистора.
Удельные емкости перекрытия CGDO и CGSO:
Cзс Сзи СOX Dпер
— удельные емкости перекрытия затвор-исток и затвор-сток (на единицу
ширины канала), [Ф/м].
Удельные емкости pn-переходов CJ и CJSW:
0 Si
C j
d
— удельная донная емкость перехода исток (сток) – подложка (на единицу площади
pn
истока (стока)), Ф/м2.
C jsw C j x j
— удельная боковая емкость перехода исток (сток) – подложка (на единицу
периметра истока (стока)), Ф/м.
Варианты заданий


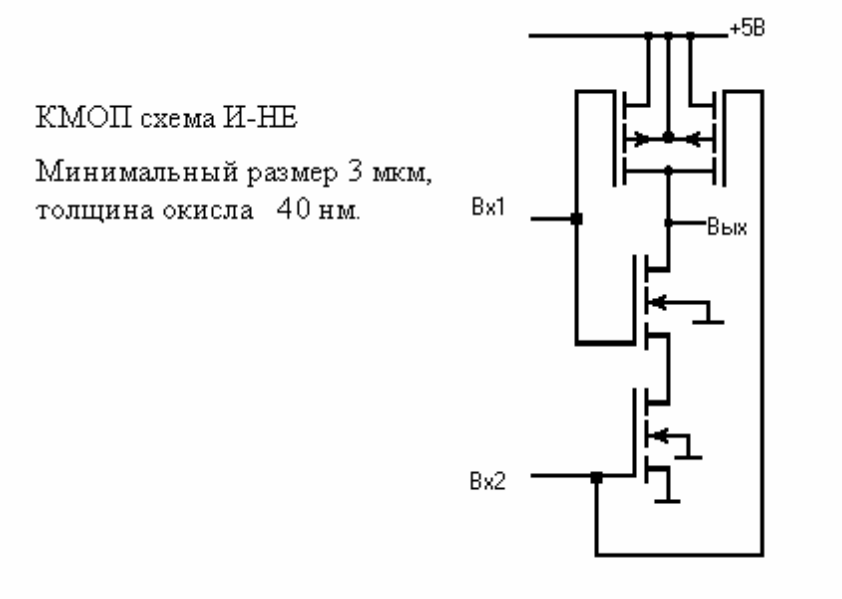
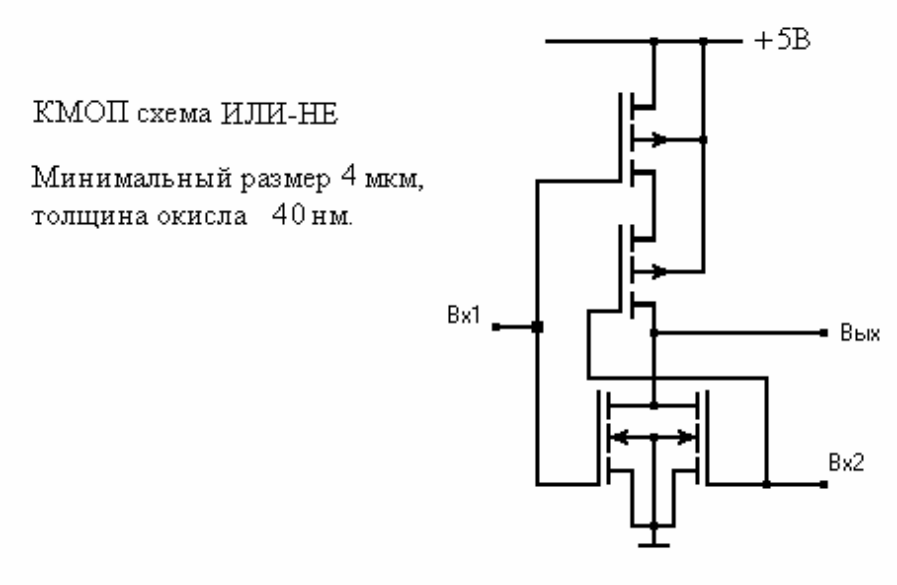
№ 3 № 4

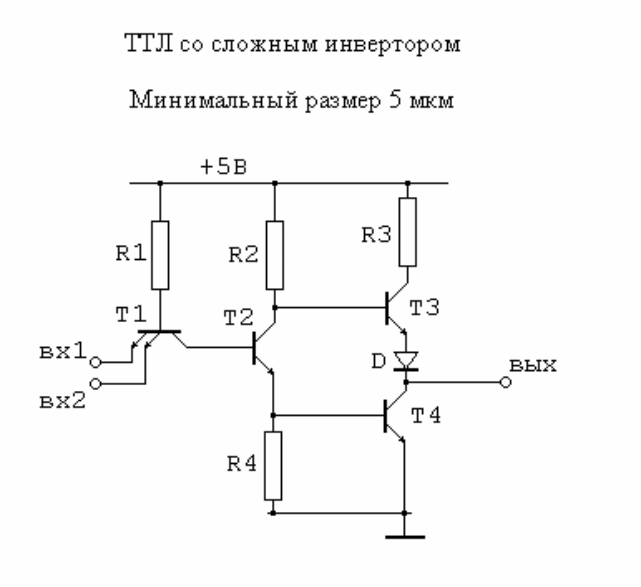
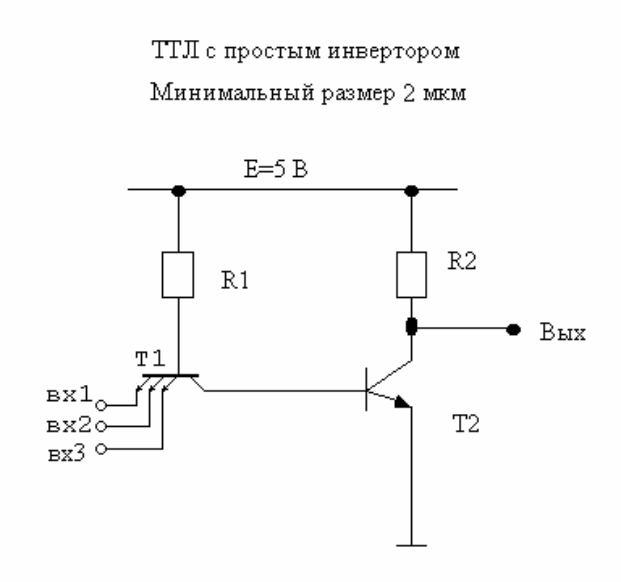
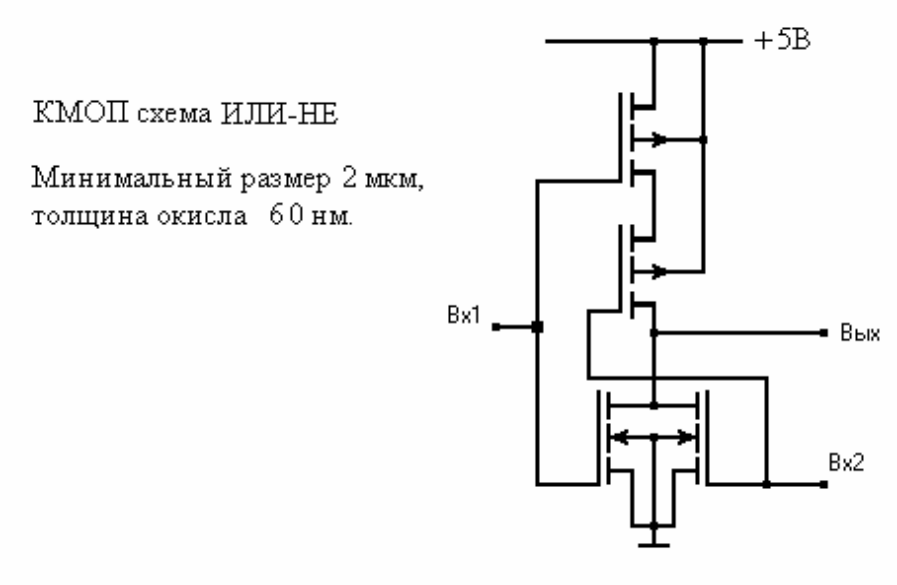
№ 7 № 8

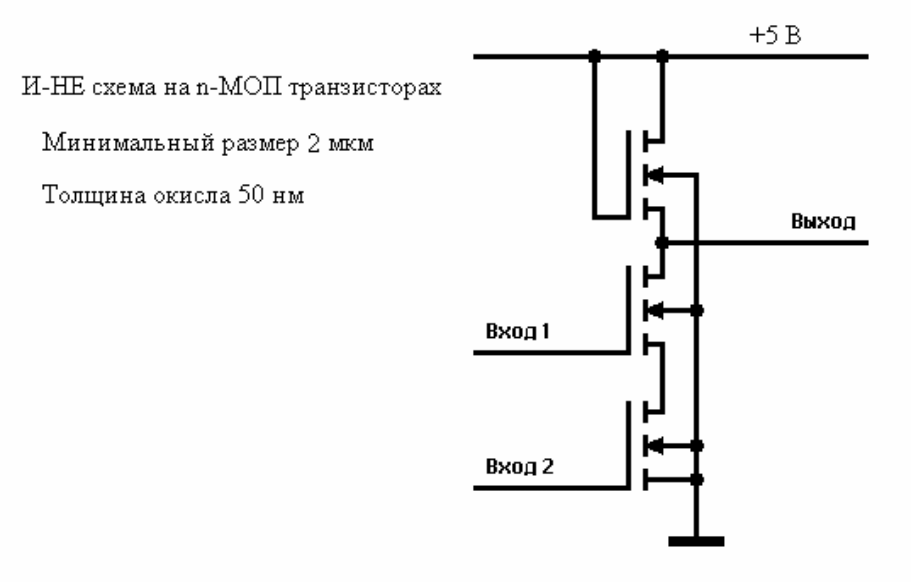
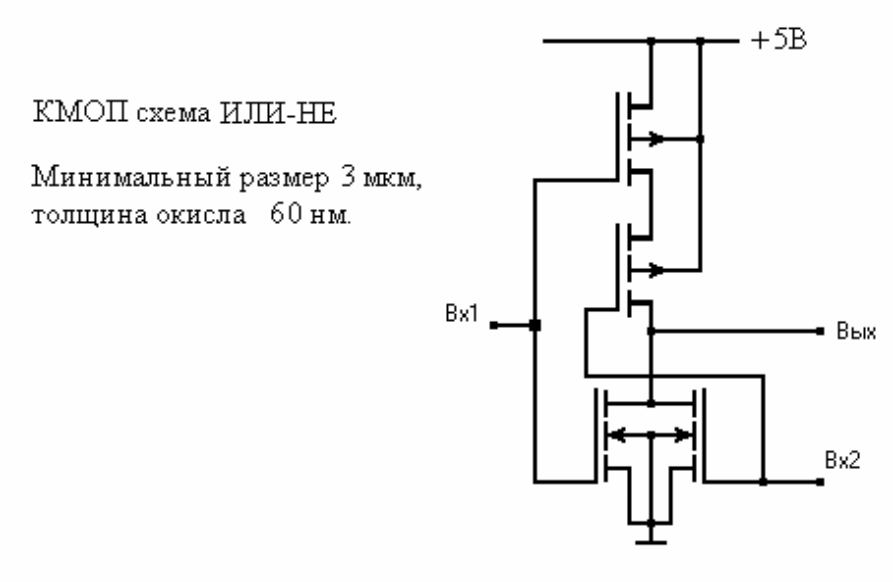
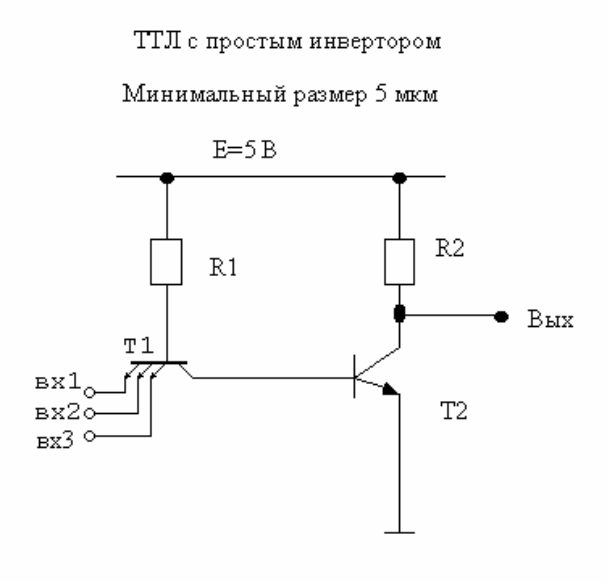
№ 11 № 12

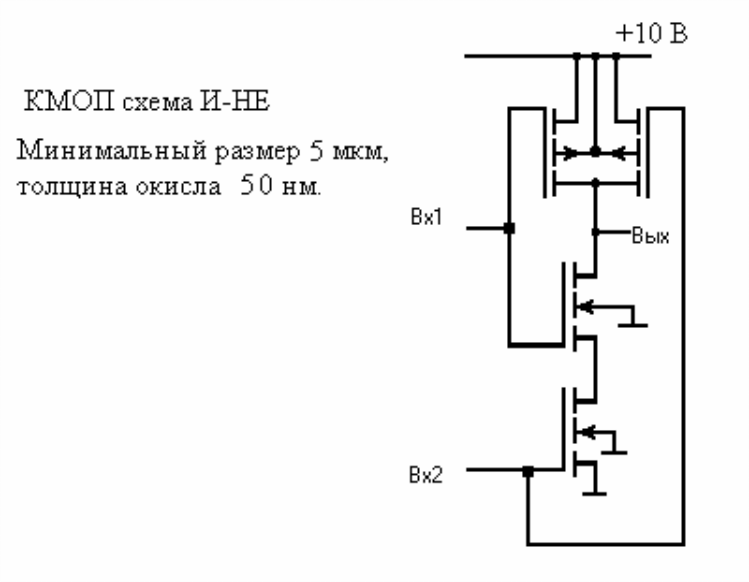
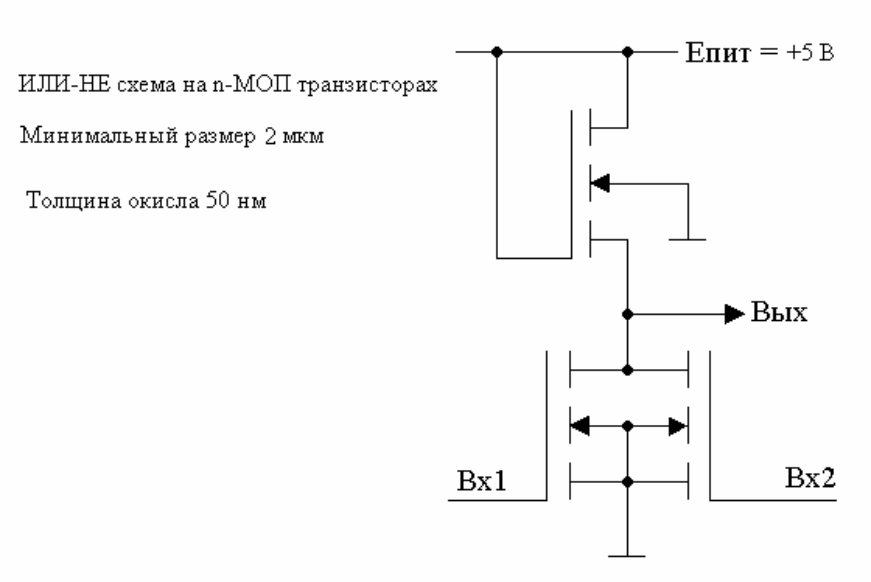
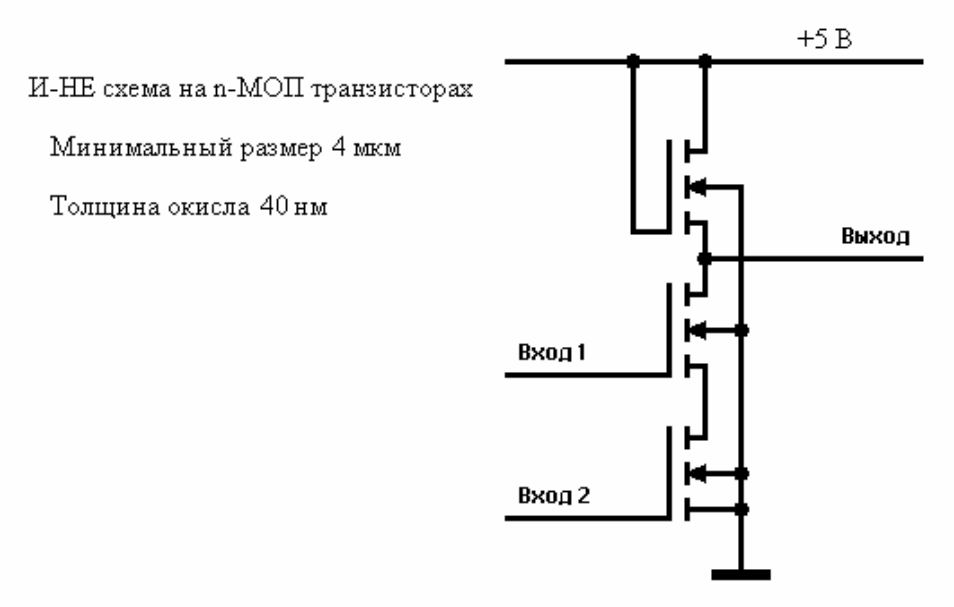
№ 15 № 16
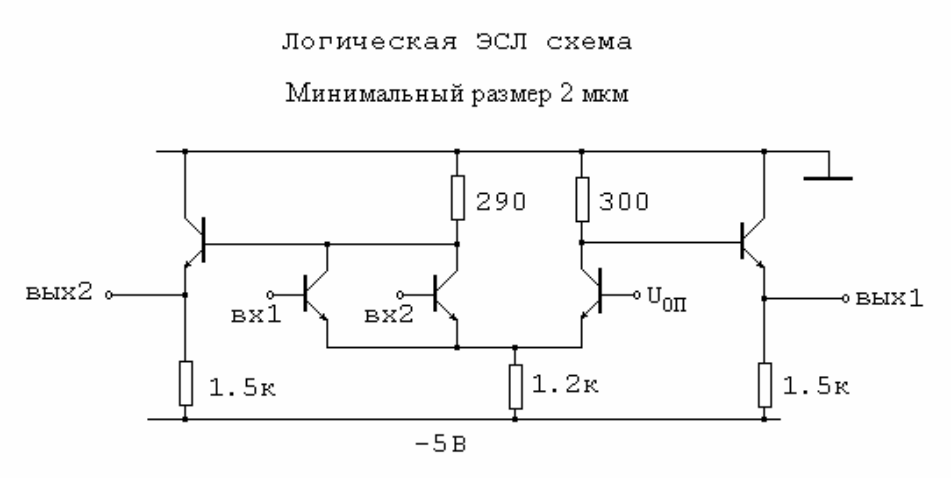

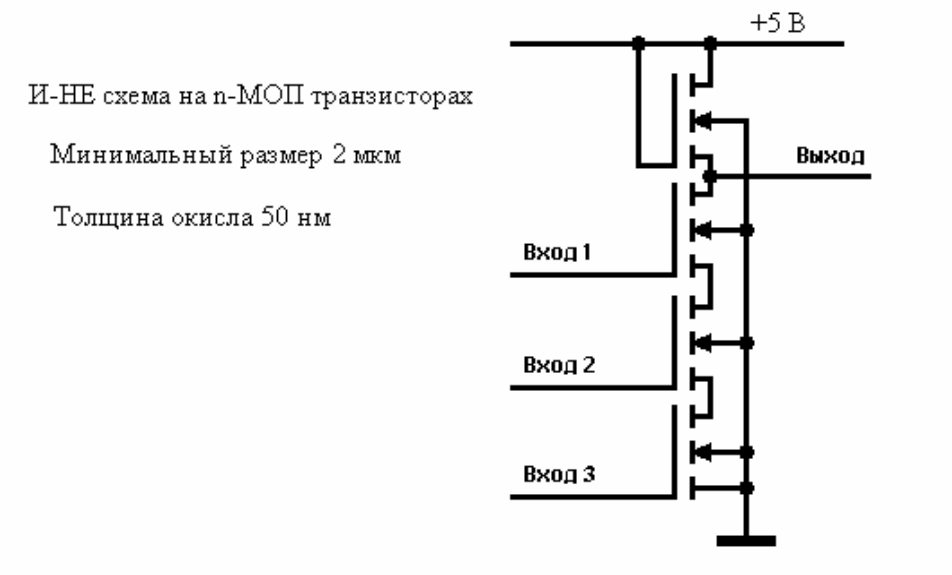

№ 19 № 20
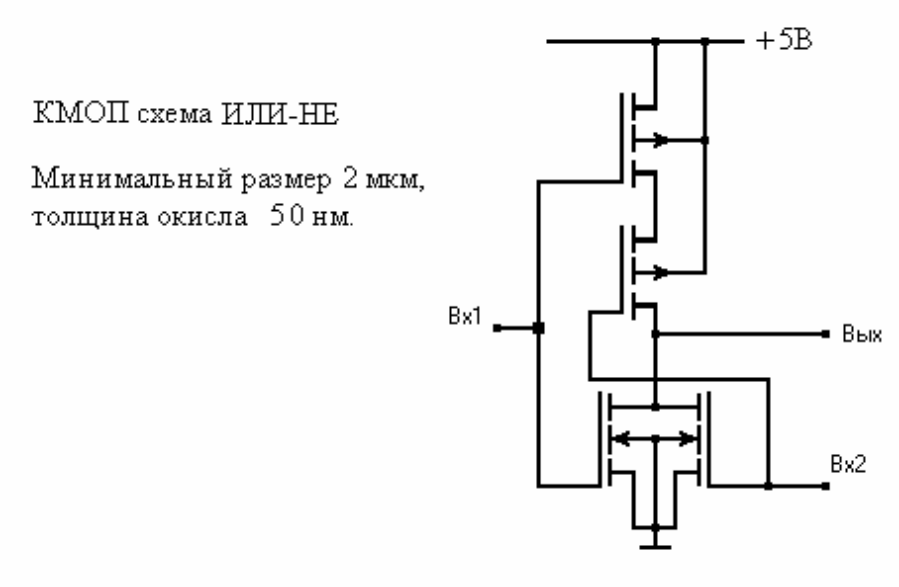
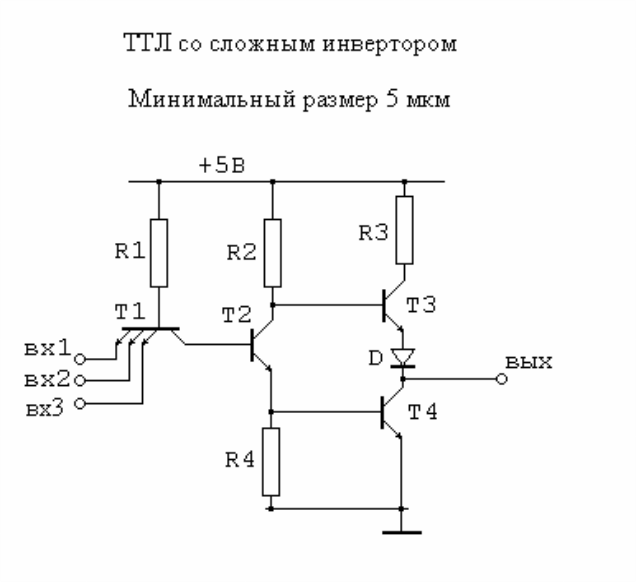
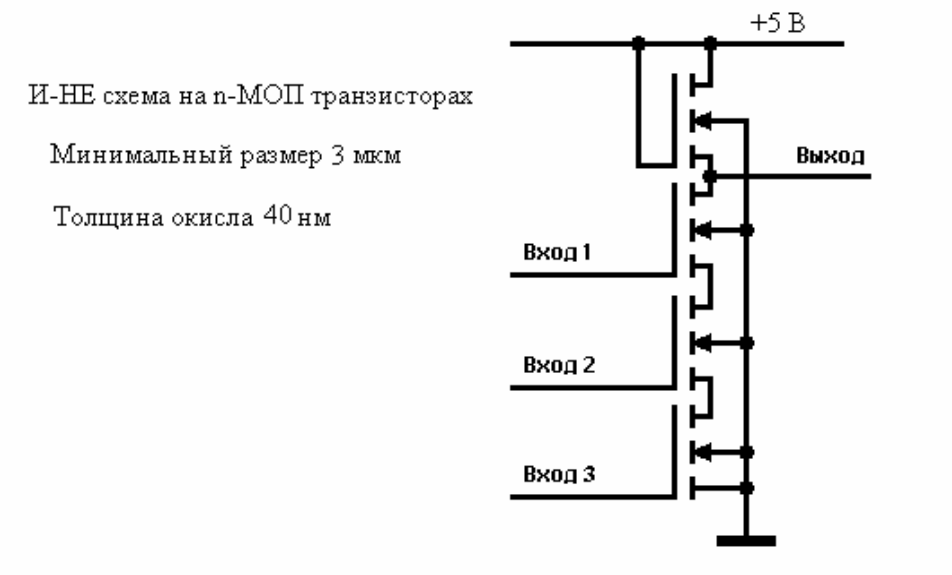
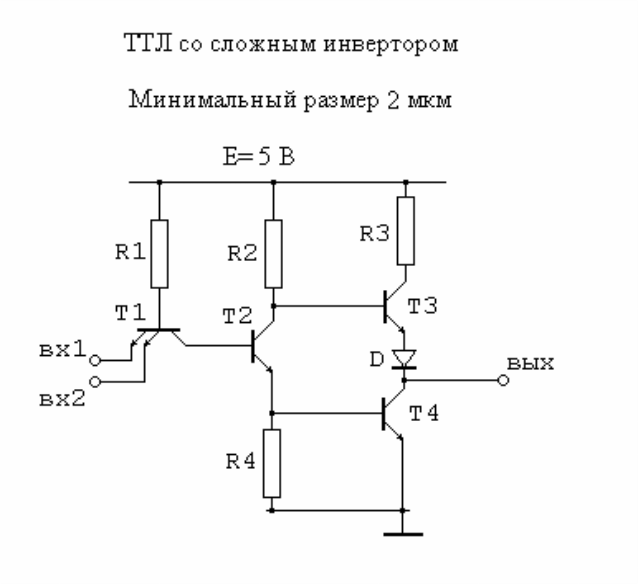
№ 23 № 24
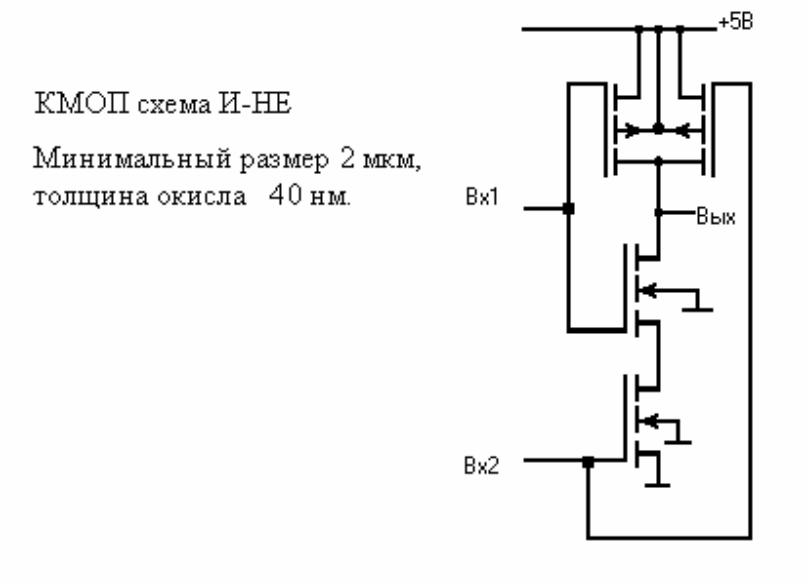
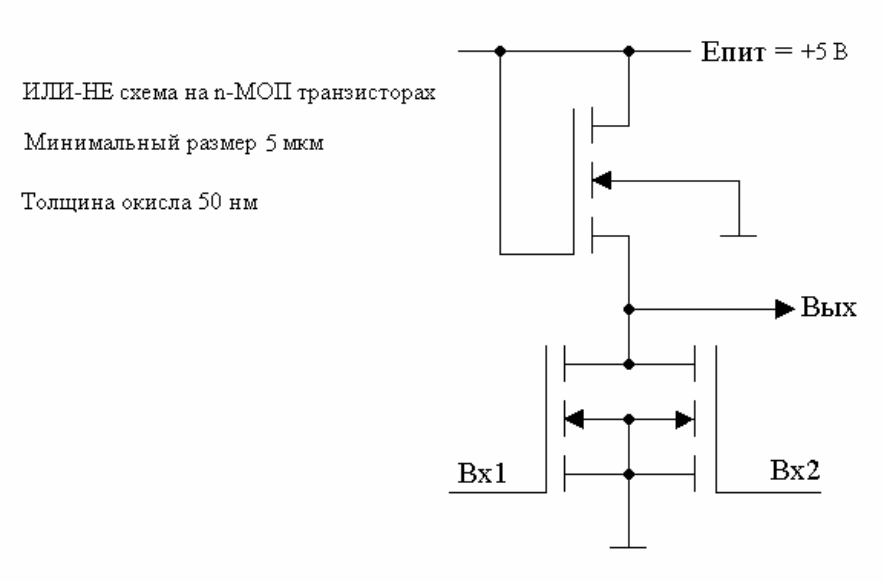
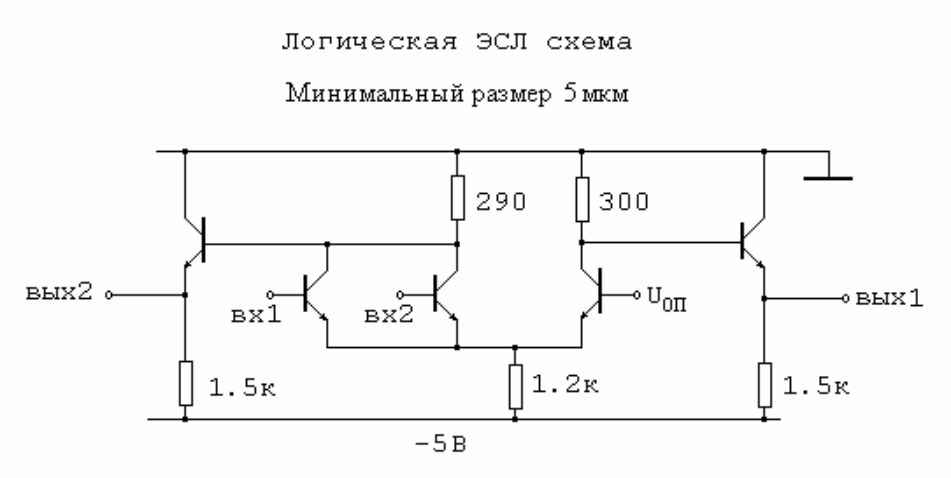
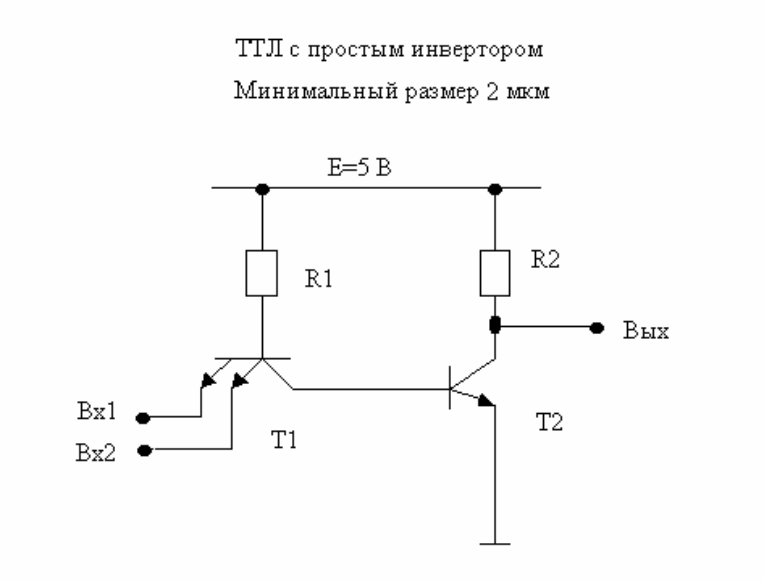
№ 27 № 28






Отзывы
Отзывов пока нет.